
Hdi Capability
Template: desktop two
HDI Technology in Hole
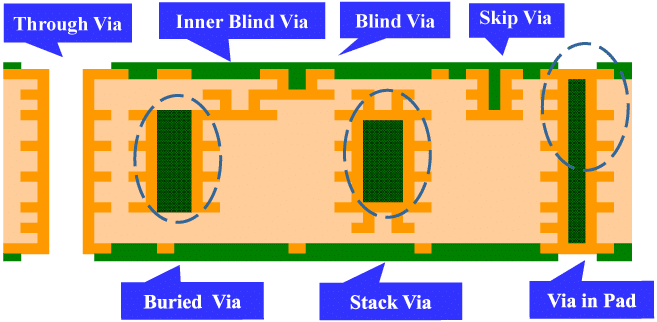
High Density Interconnection

Blind & Burried 9+2+9 Laser Drill
Market Trend vs. Technology Solution

HDI Process Flow
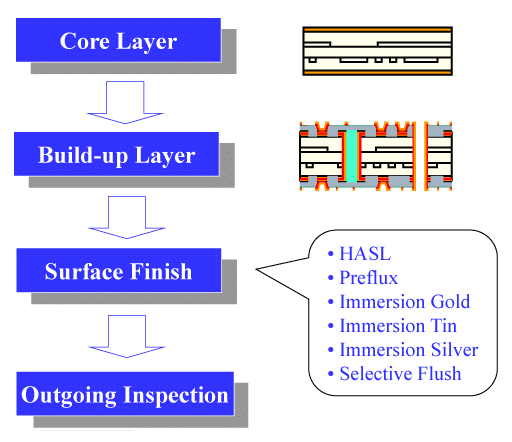
Main Process of Build – up Layer
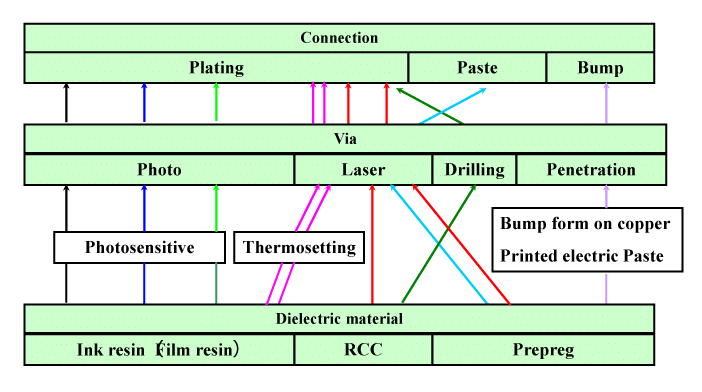
Construction Materials
Material Type
- FR 4 Tetra Function ( Tg. 130 – 140 ℃ )
- FR 4 High Tg ( Tg. 160 – 180 ℃ )
- RCC ( Tg. 150 ℃ & Tg. 185 ℃ )
- Ink ( VIL )
Comparison of Material
Comparison of Via Technologies
Comparison of Blind Via
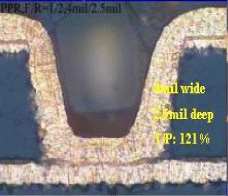

Build-up for 2 + N + 2
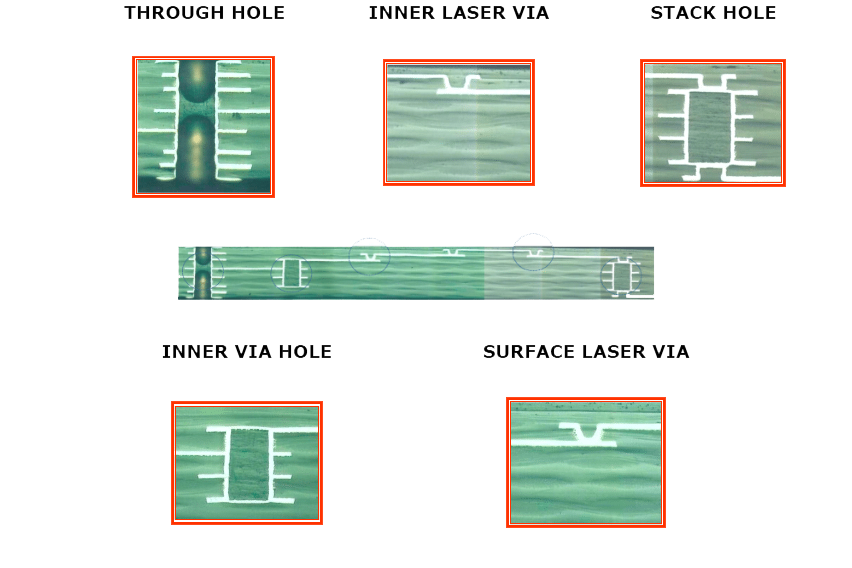
1+6+1 without buried, extend to 1+N+1

1+4+4+1 with buried via, extend to 1+N+N+1
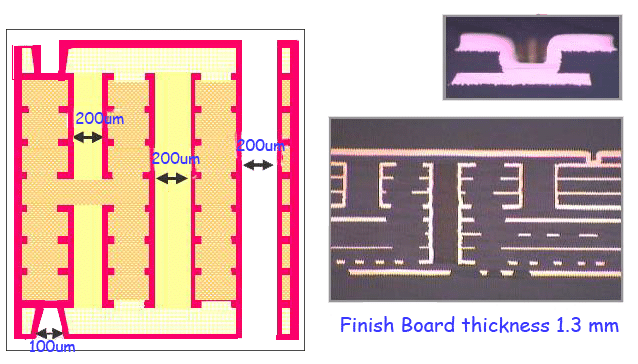
Black Oxide Treatment
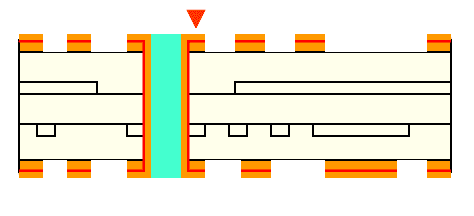
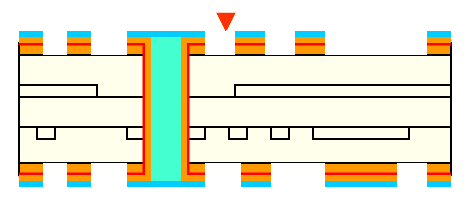
D.F. Exposure / Developing
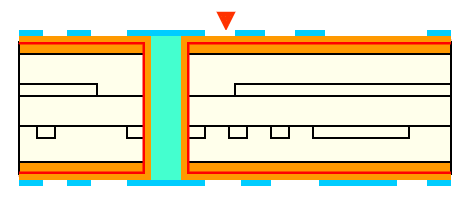
Dry Film Lamination
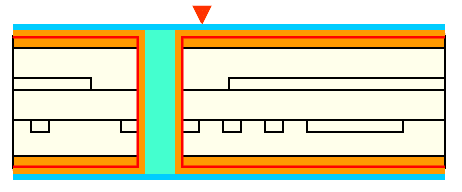
I.V.H.Grinding ( for thickness >= 60 mil )

Inner Via Hole Plugging ( for thickness >= 60 mil )

Electroless Copper Plating
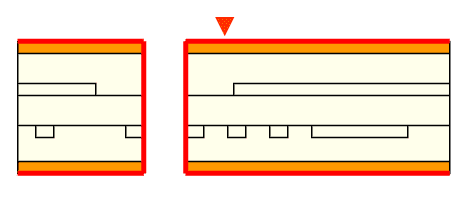
I.V.H.(Inner Via Hole) Drilling
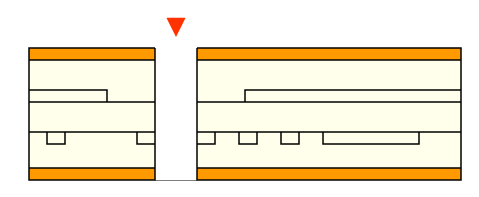
I.V.H.(Inner Via Hole) Drilling

Blind via Capability
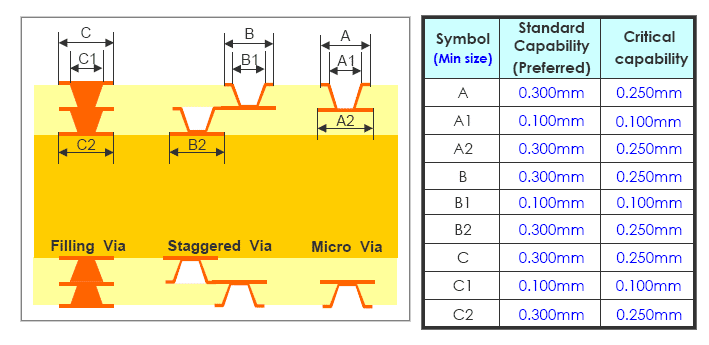
2+4+2 Staggered via, extend to 2+N+2
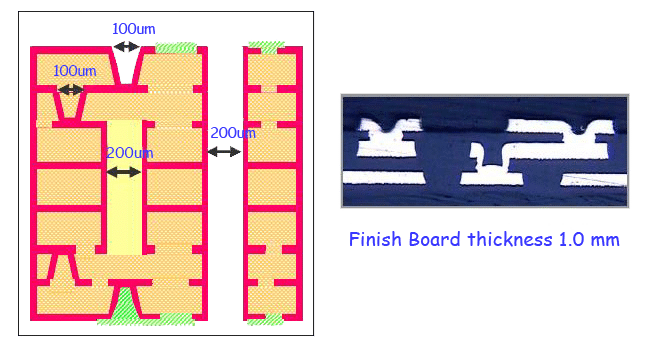
2+4+2 Staggered via, extend to 2+N+2
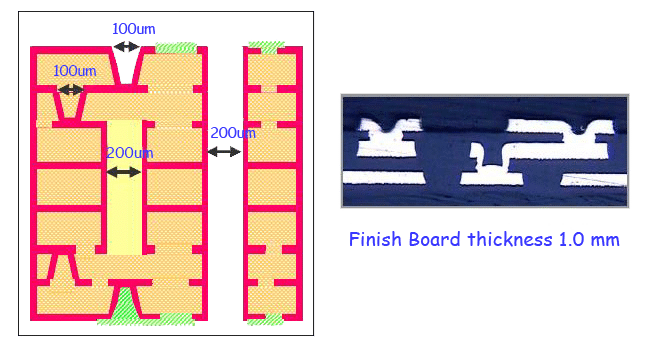
2+4+2 laser via on laser via
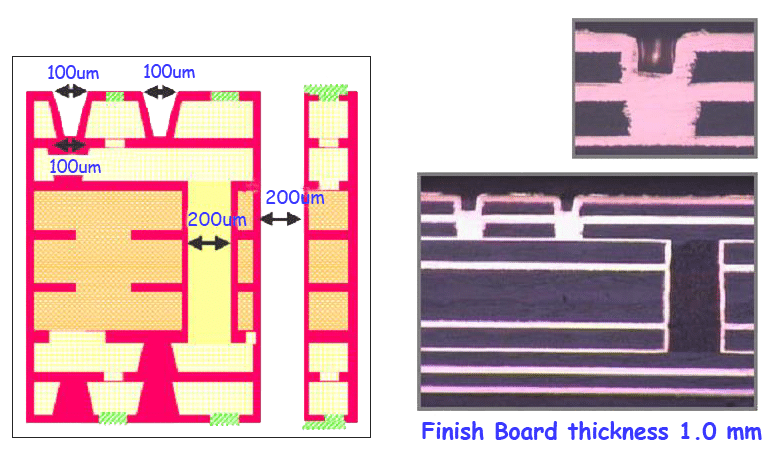
Solder Mask Printing
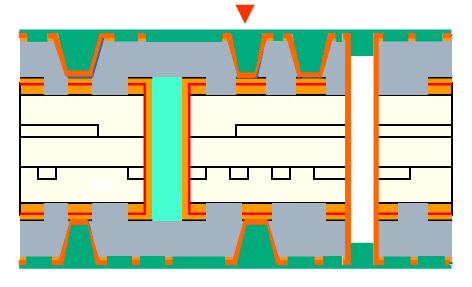
Dry Film Lamination
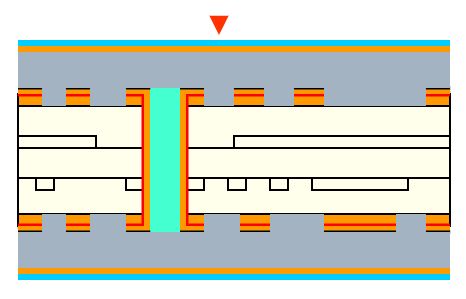
Lamination
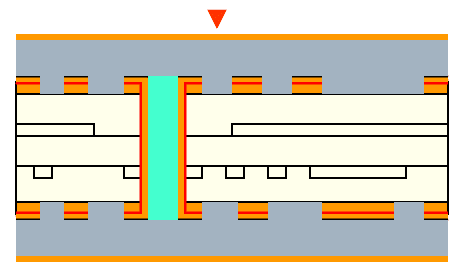
Prepreg Layup

Black Oxide Treatment

D.F. Exposure / Developing

D.F. Exposure / Developing
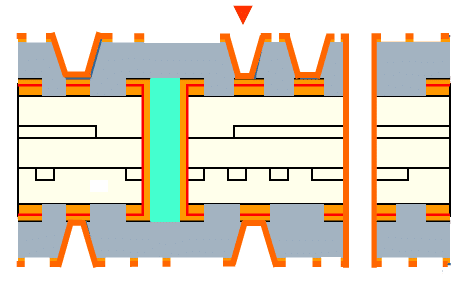
Electro Plating
Desmear / Electroless Copper Plating
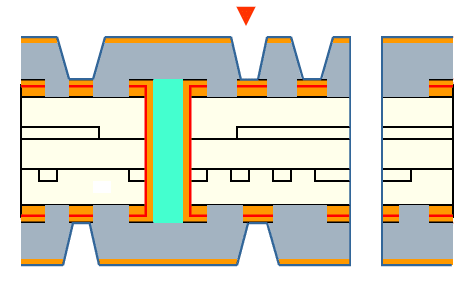
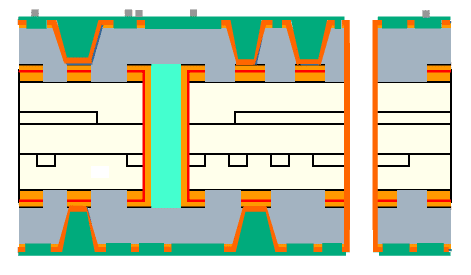
D.F. Strip
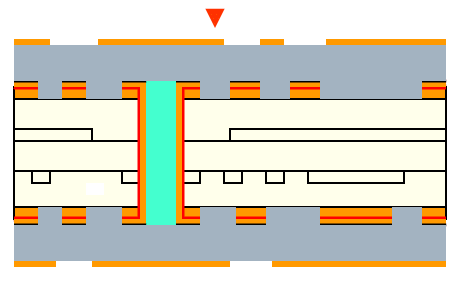
Etching
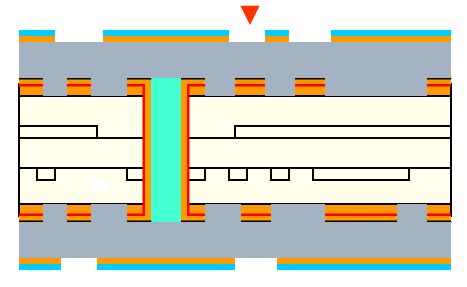
S/M Exposure / Developing
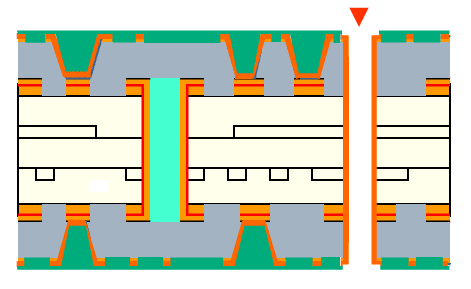
Surface Finish